Tercera parte del artículo escrito por Adam Chidley, European Senior Product Manager de Componentes Pasivos de Avnet Abacus sobre la segunda generación de sensores MEMS 3D. En este último capítulo se explica la tecnología de encapsulado en sensores MEMS 3D.
La conexión eléctrica a los dispositivos MEMS tiene que producirse a través de las capping wafers. Murata fue uno de los primeros fabricantes en utilizar TSV (Through–Silicon Vias) para lograrlo. En efecto, cada TSV es un hueco en la oblea, relleno con silicio para crear un “cable” al dispositivo MEMS. El silicio de los huecos se aísla de la oblea “grande” con una capa de vidrio, que permite beneficiarse de una elevada resistencia de aislamiento y baja capacitancia parásita entre las TSV. Todo ello dota de mejoras en precisión, estabilidad y eficiencia energética.
Y, como las TSV se forman por grabado, se puede ubicar en cualquier lugar de la capping wafer, a diferencia de lo que sucede con alternativas wire bonding, donde la distribución de los dispositivos tiene que quedar de tal forma que los hilos vayan al borde del chip para facilitar la conexión.
Después de un test de sonda inicial de los sensores MEMS 3D, se ensambla un ASIC, que lleva a cabo las operaciones matemáticas, en la parte inferior del sándwich de oblea MEMS / capping usando tecnología flip–chip (sólo los sitios bien conocidos son “poblados”). Posteriormente, se efectúa el test final del cien por cien de los componentes, seguido por la calibración de los sensores. El espacio alrededor del ASIC se rellena con plástico moldeado (robusto y fiable) que, de nuevo, ayuda a salvaguardar ante la presencia de choque y vibración. Aunque este proceso es totalmente diferente al del encapsulado de circuitos impresos estándares, consigue mantener un formato bonito y compacto.
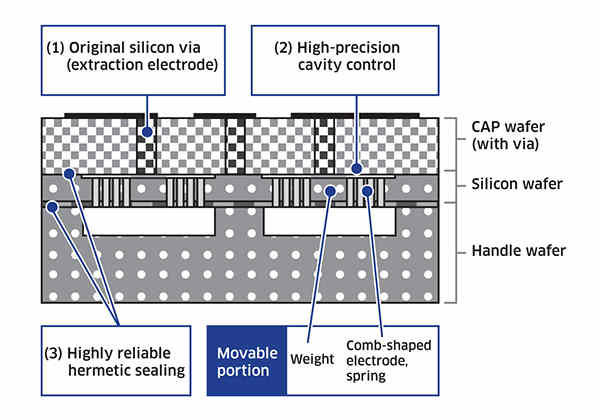
Logros de la tecnología de encapsulado en sensores MEMS 3D
El resultado de los nuevos diseños de dispositivos MEMS 3D, combinados con procesos de precisión y tecnología innovadora de encapsulado, es una serie de dispositivos que puede resistir los entornos más adversos, como los encontrados en automoción y aplicaciones industriales.
Además, el rendimiento y la fiabilidad se han comprobado sobre el terreno, ofreciendo la precisión demandada en proyectos con presencia de vibración y temperaturas extremas. Los componentes también cuentan con una excelente resistencia al choque mecánico y estabilidad de compensación a lo largo del tiempo.
Si está interesado en obtener mayor información sobre la segunda generación de sensores MEMS 3D, siga nuestro consejo: contacte con su especialista local o visite el apartado “Pregunte al Experto” del blog de Avnet Abacus.