La nueva tecnología 3D-TSV de doce capasde Samsung permite el apilado de doce chips DRAM al usar más de 60.000 huecos TSV y mantiene el grosor de los actuales chips de ocho capas.
Samsung Electronics anuncia el desarrollo de la primera tecnología 3D-TSV (Through Silicon Via) de doce capas. Esta innovación se considera como una de las “más prometedoras” para la producción masiva de chips de alto rendimiento, ya que requiere la máxima precisión al interconectar verticalmente doce chips DRAM en una configuración tridimensional de más de 60.000 huecos TSV, cada uno de los cuales tiene un grosor de una veinteava parte de un cabello.
El grosor del encapsulado (720 ㎛) es el mismo de los actuales productos High Bandwidth Memory-2 (HBM2) de ocho capas, un avance sustancial en el diseño de componentes. Esto ayudará a los clientes a lanzar productos de alta capacidad de próxima generación con mayor capacidad de rendimiento sin tener que cambiar la configuración del sistema.
El encapsulado 3D también se caracteriza por un menor tiempo de transmisión de datos entre chips con respecto a la tecnología wire bonding, lo que se traduce en más velocidad y menos consumo.
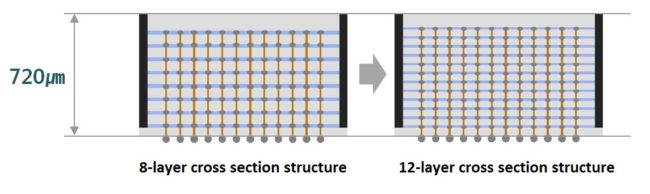
“La tecnología de packaging que resuelva todas las complejidades de la memoria de elevado rendimiento tendrá una tremenda importancia con la llegada de una nueva era de aplicaciones, como inteligencia artificial (IA) o High Power Computing (HPC)”, afirma Hong-Joo Baek, Vicepresidente Ejecutivo de TSP (Test & System Package) de Samsung Electronics. “Como la escala de la ley de Moore alcanza su límite, se espera que la tecnología 3D-TSV sea cada vez más esencial. Por ello, queremos estar a la vanguardia de esta tecnología de encapsulado”.
Confiando en su tecnología 3D-TSV de doce capas, Samsung ofrecerá el mayor rendimiento DRAM en aplicaciones con gran cantidad de datos y velocidad extrema.
Además, al incrementar el número de capas apiladas de ocho a doce. Samsung podrá producir High Bandwidth Memory de 24 GB, el triple de capacidad de las soluciones existentes en el mercado.